Intel公开三项全新封装技术:灵活、高能集成多芯片
信息来源: http://www.emcmy.com 时间:2019/7/11 15:28:32
在本周旧金山举办的SEMICON West大会上,Intel介绍了三项全新的先进芯片封装技术,并推出了一系列全新基础工具,包括EMIB、Foveros技术相结合的创新应用,新的全方位互连(ODI)技术等。
作为芯片制造过程的最后一步,封装在电子供应链中看似不起眼,却一直发挥着极为关键的作用。作为处理器和主板之间的物理接口,封装为芯片的电信号和电源提供着陆,尤其随着行业的进步和变化,先进封装的作用越来越凸显。
另一方面,半导体工艺和芯片架构的日益复杂,传统SoC二维单芯片思路已经逐渐行不通,chiplet多个小芯片封装成为大势所趋。
Intel正是利用先进技术,将芯片和小芯片封装在一起,达到SoC的性能,而异构集成技术提供了前所未有的灵活性,能够混搭各种IP和工艺、不同的内存和I/O单元,Intel的垂直集成结构在异构集成时代尤其独具优势。
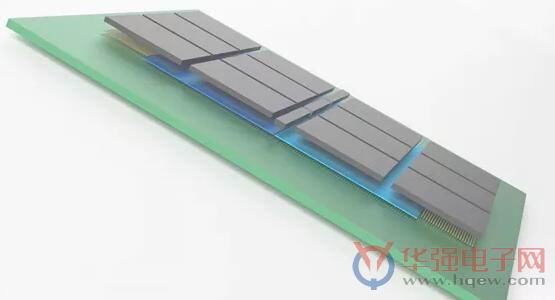
Intel此次公布的三项全新封装技术分别是:
一、Co-EMIB
利用利用高密度的互连技术,将EMIB(嵌入式多芯片互连桥接) 2D封装和Foveros 3D封装技术结合在一起,实现高带宽、低功耗,以及相当有竞争力的I/O密度。
Co-EMIB能连接更高的计算性能和能力,让两个或多个Foveros元件互连从而基本达到SoC性能,还能以非常高的带宽和非常低的功耗连接模拟器、内存和其他模块。
Foveros 3D封装是Intel在今年初的CES上提出的全新技术,首次为CPU处理器引入3D堆叠设计,可以实现芯片上堆叠芯片,而且能整合不同工艺、结构、用途的芯片,相关产品将从2019年下半年开始陆续推出。
二、ODI
ODI全程Omni-Directional Interconnect,也就是全方位互连技术,为封装中小芯片之间的全方位互连通信提供了更大的灵活性。
ODI封装架构中,顶部的芯片可以像EMIB下一样,与其他小芯片进行水平通信,还可以像Foveros下一样,通过硅通孔(TSV)与下面的底部裸片进行垂直通信。
ODI利用更大的垂直通孔,直接从封装基板向顶部裸片供电,比传统硅通孔更大、电阻更低,因而可提供更稳定的电力传输,同时通过堆叠实现更高的带宽和更低的时延。
此外,这种方法减少了基底芯片所需的硅通孔数量,为有源晶体管释放更多的面积,并优化了裸片的尺寸。
三、MDIO
基于高级接口总线(AIB)物理层互连技术,Intel发布了这种名为MDIO的全新裸片间接口技术。
MDIO技术支持对小芯片IP模块库的模块化系统设计,能效更高,响应速度和带宽密度可以是AIB技术的两倍以上。
Intel强调,这些全新封装技术将与Intel的制程工艺相结合,成为芯片架构师的创意调色板,自由设计创新产品。
铁粉芯 8材 HST50-8B
高偏流的情况下,磁芯损耗最低,兼且线性良好,是最好的高频材,也是最贵的材料OD(in/mm) ID(in/mm) HT(in/mm)0.500/12.7 0.303/7.7 0.250/6.35Al: 23 nH ±10%

铁粉芯 HST131-52 52材…
52材在高频率下磁芯损耗较低,而磁导率与材料-26相同,在新型的高频抗流器上应用广泛.OD(in/mm) ID(in/mm) HT(in/mm)1.300/33.0 0.640/16.3 0.437/11.1Al: 108 nH ±10% 初…

26材 HST157-26
26材最为通行的材料,是一种成本效益最高的一般用途材料,适合功率转换和线路滤波等各种广泛用途. OD(in/mm) ID(in/mm) HT(in/mm)2.000/50.8 1.250/31.8 1.000/25.4Al:…

铁粉芯 HST131-52
52材在高频率下磁芯损耗较低,而磁导率与材料-26相同,在新型的高频抗流器上应用广泛.OD(in/mm) ID(in/mm) HT(in/mm)1.300/33.0 0.640/16.3 0.437/11.1Al: 108 nH ±10%

 微信
微信

